

電子產品一直趨向玩弄短小、更高的運行速度,里面含有更多功能。為了達到以上要求,電子封裝行業一直著力于研發更先進的封裝辦法,既增長單板上部件的疏密程度,又將多種功能組合成單個高疏密程度封裝。
封裝和互連疏密程度的增加推動了組裝辦法從通孔技術(THT)到外表貼裝技術(SMT)的進展,況且造成更多地運用引線鍵合將芯片連署到基板。 小的互連間距和芯片級封裝(CSP)的運用要得部件疏密程度增加,而多芯片模組(MCM)/系統級封裝(SiP)要得在同一封裝上鑲嵌更多功能從沒可能成為事實。
半導體工業積年來經過減小芯片尺寸來增長部件的性能時,對于電子系統中的芯片須經過封裝你我互聯這一事情的真實情況關心注視較少。 大規模I/O及訊號傳道輸送品質的要求,使封裝變成半導體工業的關緊思索問題因素。為了滿意封裝工藝要求,成功實現靠得住的連署,不管IC封裝內成功實現互連的基板還是部件二級封裝互聯的PCB,線路板的外表處置技術都尤為關緊。
本文描寫了影響互連靠得住性的關鍵因素,特別偏重金線鍵合應用的外表處置特別的性質。
固然電鍍鎳金供給了特別好的金線鍵合的性能,但它存在三個主要欠缺,每個欠缺都阻攔其在最前沿應用中運用:
需求相對較高的金層厚度,工藝成本頎長。
厚金層容易萌生薄弱的錫-金金屬間化合物(IMC),焊點之靠得住性減低。為了增加焊點之靠得住性,可在需求焊錫的地方運用不一樣的外表處置,不過卻會增加另外的工藝成本。
電鍍工藝需求運用電鍍線,限止了封裝載板的預設自由度和布線疏密程度。
電鍍鎳金的這些個限止為化學鍍的挑選供給了空間。化學鍍的技術涵蓋化學鍍鎳浸金(ENIG),化學鍍鎳化學鍍金(ENEG)及化學鍍鎳鈀浸金(ENEPIG)。
在這三種挑選中,ENIG是基本上無須思索問題的,由于它不具備高靠得住性金線鍵合特別的性質(盡管它已被用于一點低端消費產品中),而ENEG具備和電鍍鎳金一樣高的生產資本,在工藝方面亦飽含復雜挑戰。
固然化學鍍鎳鈀浸金(ENEPIG)起初是在20百年90時代末顯露出來的,但其市場接納度卻被2000年左右鈀金屬價錢的撩動延遲所延遲(2000年時,鈀金屬價錢被炒到不符合理的高位)。 不過ENEPIG可以滿意很多新的封裝應用,滿意靠得住性需要,同時滿意無鉛/ ROHS要求,近年市場需要閃現強有力提高。
除開在封裝靠得住性的優勢上,ENEPIG的成本則是另一優勢。近年金價升漲超過US$800/oz,要求電鍍厚金的電子產品便很難扼制成本。而鈀金屬的價錢(US$300/oz)相對于金價來說遠低于二分之一,用鈀接替金則有表面化優勢。
到現在為止適應纖小引腳的QFP/BGA部件的線路板,主要有4種無鉛外表處置
化學浸錫(Immersion Tin)
化學浸銀(Immersion silver)
有機焊錫盡力照顧劑(OSP)
化學鍍鎳浸金(ENIG)
下表列舉出這4種外表處置跟ENEPIG的相比較。在這4種外表處置中,沒有一種外表處置能同時滿意無鉛組裝工藝的全部需要,特別是當思索問題到多重再流焊有經驗、組裝前的耐儲時間及金線鍵合有經驗。相反,ENEPIG卻有良好耐儲時間,焊點靠得住度,金線鍵合有經驗和能夠作為按鈕觸摸外表,有表面化優勢。并且ENEPIG在最終置換金的淤積反響中,化學鍍鈀層會盡力照顧鎳層避免被置換金過度腐蝕。
表 1 – 不一樣外表處置性能之比較

從各外表處置在不一樣組裝辦法上的表達來看,ENEPIG能夠同時滿意多種不一樣組裝的要求。
表2–不一樣外表處置對不一樣組裝辦法之表達
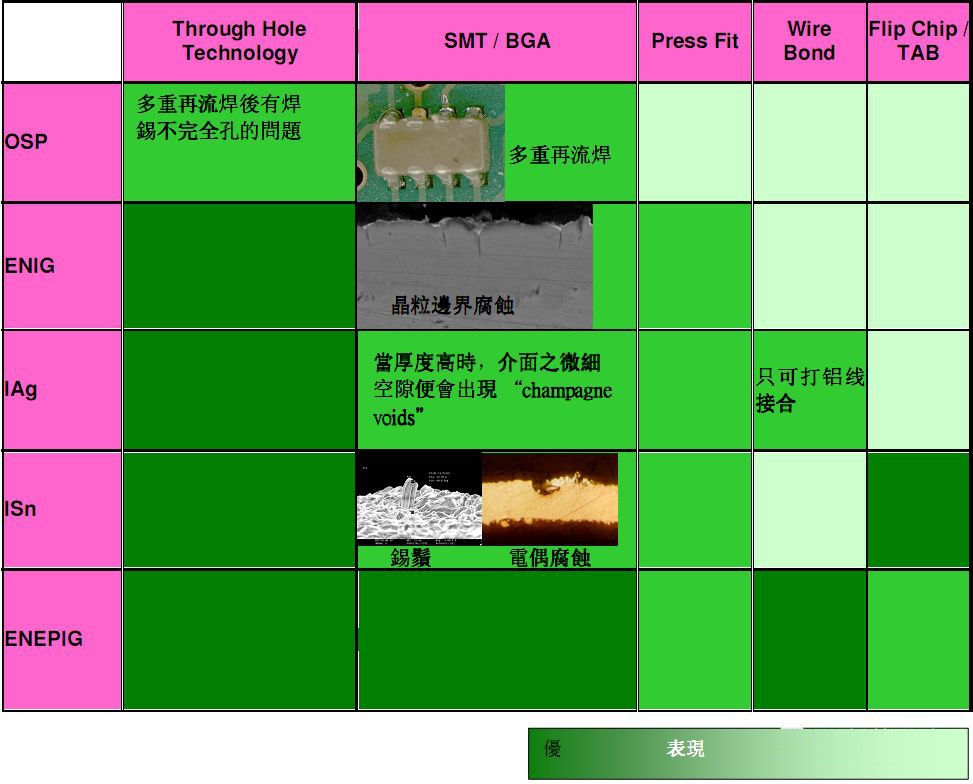
在相同金線鍵合的條件下(用第二焊點張力測試2nd bond pull test),ENEPIG表達出跟電鍍鎳金相近的金線鍵合靠得住性。


在ENEPIG樣本抗張力測試中,仔細查看到主要的金線鍵合失去效力標準樣式是斷開在金線中部及非常之小量的在頸狀部位。沒有金線不結合和結合點斷裂的事情狀況發生。

此測試最后結果顯露出ENEPIG在金線鍵合上能夠美好的接替電鍍鎳金。
ENEPIG最關緊的長處是同時間有良好的錫焊靠得住性及金線鍵合靠得住性,細列舉如下所述:
1、避免“黑鎳問題”的發生——沒有置換金殲擊鎳的外表導致晶界腐蝕
2、化學鍍鈀會作為阻止層,阻擋銅向外表的廓張,因此保證令人滿意的可焊性
3、化學鍍鈀層會絕對溶解在焊料當中,在合金界面上不會有高磷層的顯露出來。同時當化學鍍鈀溶解后會露出化學鍍鎳層用來世成令人滿意的鎳-錫合金
4、能承擔多次無鉛再流焊循環
5、有良好的金線鍵合特別的性質
6、工藝成本比電鍍鎳金及化學鍍鎳金低
ENEPIG(鎳鈀金)的長處

文章來自:www.caqcyp.com(愛彼電路)是精密PCB線路板生產廠家,專業生產微波線路板,rogers高頻板,羅杰斯電路板,陶瓷電路板,HDI多層電路板,FPC軟硬結合板,盲埋孔電路板,鋁基板,厚銅電路板