

淺談內(nèi)存芯片封裝技術(shù)
很多關(guān)注電腦核心配件發(fā)展的朋友都會注意到,一般新的CPU內(nèi)存以及芯片組出現(xiàn)時都會強調(diào)其采用新的封裝形式,不過很多人對封裝并不了解。其實,所謂封裝就是指安裝半導(dǎo)體集成電路芯片用的外殼,它不僅起著安放、固定、密封、保持芯片和增強電熱性能的作用。內(nèi)存顆粒的封裝方式最常見的有SOJ、TSOP II、Tiny-BGA、BLP、μBGA等封裝,而未來趨勢則將向CSP發(fā)展。
1.SOJ(Small Out-Line J-Lead)小尺寸J形引腳封裝
SOJ封裝方式是指內(nèi)存芯片的兩邊有一排小的J形引腳,直接黏著在印刷電路板的表面上。它是一種表面裝配的打孔封裝技術(shù),針腳的形狀就像字母"J",由此而得名。SOJ封裝一般應(yīng)用在EDO DRAM。
2.Tiny-BGA(Tiny Ball Grid Array)小型球柵陣列封裝
TinyBGA英文全稱為Tiny Ball Grid Array(小型球柵陣列封裝),屬于是BGA封裝技術(shù)的一個分支。是Kingmax公司于1998年8月開發(fā)成功的,其芯片面積與封裝面積之比不小于1:1.14,可以使內(nèi)存在體積不變的情況下內(nèi)存容量提高2~3倍,與TSOP封裝產(chǎn)品相比,其具有更小的體積、更好的散熱性能和電性能。采用TinyBGA封裝技術(shù)的內(nèi)存產(chǎn)品在相同容量情況下體積只有TSOP封裝的1/3。采用TinyBGA封裝芯片可抗高達300MHz的外頻,而采用傳統(tǒng)TSOP封裝技術(shù)最高只可抗150MHz的外頻。TinyBGA封裝的內(nèi)存其厚度也更薄(封裝高度小于0.8mm),從金屬基板到散熱體的有效散熱路徑僅有0.36mm。因此,TinyBGA內(nèi)存擁有更高的熱傳導(dǎo)效率,非常適用于長時間運行的系統(tǒng),穩(wěn)定性極佳。
3.BLP(Bottom Lead PacKage)底部引交封裝
樵風(fēng)(ALUKA)金條的內(nèi)存顆粒采用特殊的BLP封裝方式,該封裝技術(shù)在傳統(tǒng)封裝技術(shù)的基礎(chǔ)上采用一種逆向電路,由底部直接伸出引腳,其優(yōu)點就是能節(jié)省約90%電路,使封裝尺寸電阻及芯片表面溫度大幅下降。和傳統(tǒng)的TSOP封裝的內(nèi)存顆粒相比,其芯片面積與填充裝面積之比大于1:1.1,明顯要小很多,不僅高度和面積極小,而且電氣特性得到了進一步的提高,制造成本也不高,BLP封裝與KINGMAX的TINY-BGA封裝比較相似,BLP的封裝技術(shù)使得電阻值大幅下降,芯片溫度也大幅下降,可穩(wěn)定工作的頻率更高。
4.SIMM(single in-line memory module)單內(nèi)置內(nèi)存模型
SIMM模塊包括了一個或多個RAM芯片,這些芯片在一塊小的集成電路板上,利用電路板上的引腳與計算機的主板相連接。因為用戶需要對內(nèi)存進行擴展,只需要加入一些新的SIMM就可以了。SIMM根據(jù)內(nèi)存顆粒分布可以分為單面內(nèi)存和雙面內(nèi)存,一般的容量為1、4、16MB的SIMM內(nèi)存都是單面的,更大的容量的SIMM內(nèi)存是雙面的。72線SIMM內(nèi)存條可支持32位的數(shù)據(jù)傳輸,在586主板基本上都提供的是72線SIMM內(nèi)存插槽。需要注意的是,Pentium處理器的數(shù)據(jù)傳輸是64位的,現(xiàn)在采用Intel的Triton或Triton Ⅱ芯片組的586主板需要成對的使用這種內(nèi)存條;而采用SIS芯片組的586主板由于SIS芯片采用了一些特殊的技術(shù),能夠使用單條的72線內(nèi)存條。
5.DIMM(dual in-line memory module)雙內(nèi)置存儲模型
DIMM模塊是目前最常見的內(nèi)存模塊,它是也可以說是兩個SIMM。它是包括有一個或多個RAM芯片在一個小的集成電路板上,利用這塊電路板上的一些引腳可以直接和計算機主板相連接。DIMM是目前我們使用的內(nèi)存的主要封裝形式,比如SDRAM、DDR SDRAM、RDRAM,其中SDRAM具有168線引腳并且提供了64bit數(shù)據(jù)尋址能力。DIMM的工作電壓一般是3.3v或者5v,并且分為unbuffered和buffered兩種。而SIMM和DIMM內(nèi)存之間不僅僅是引腳數(shù)目的不同,另外在電氣特性、封裝特點上都有明顯的差別,特別是它們的芯片之間的差別相當?shù)拇蟆,F(xiàn)在的高密度DRAM芯片可以具有不止一個Din和Dout信號引腳,并且可以根據(jù)不同的需要在DRAM芯片上制造4、8、16、32或者64條數(shù)據(jù)引腳。在Pentium級以上的處理器是64位總線,使用這樣的內(nèi)存更能發(fā)揮處理器的性能。
6.TSOP(Thin Small Outline Package)薄型小尺寸封裝。
TSOP內(nèi)存封裝技術(shù)的一個典型特征就是在封裝芯片的周圍做出引腳,如SDRAM內(nèi)存的集成電路兩側(cè)都有引腳,SGRAM內(nèi)存的集成電路四面都有引腳。TSOP適合用SMT技術(shù)(表面安裝技術(shù))在PCB(印制電路板)上安裝布線。TSOP封裝外形尺寸時,寄生參數(shù)(電流大幅度變化時,引起輸出電壓擾動) 減小,適合高頻應(yīng)用,操作比較方便,可靠性也比較高。改進的TSOP技術(shù)目前廣泛應(yīng)用于SDRAM內(nèi)存的制造上,不少知名內(nèi)存制造商如三星、現(xiàn)代、Kingston等目前都在采用這項技術(shù)進行內(nèi)存封裝。不過, TSOP封裝方式的內(nèi)存在超過150MHz后,會產(chǎn)品較大的信號干擾和電磁干擾。
7.BGA(Ball Grid Array)球狀矩陣排列封裝
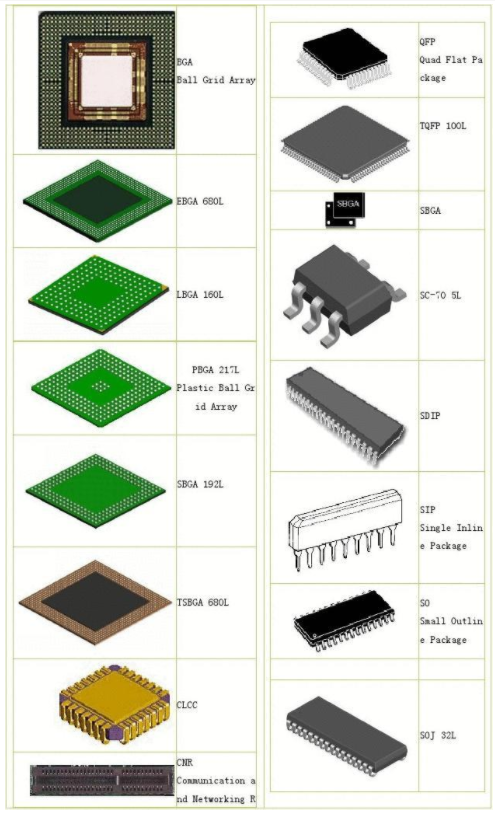
(同8芯片級封裝)
8.CSP(Chip Scale Package)芯片級封裝
CSP作為新一代的芯片封裝技術(shù),在BGA、TSOP的基礎(chǔ)上,它的性能又有了革命性的提升。
CSP,全稱為Chip Scale Pack-age,即芯片尺寸封裝的意思。作為新一代的芯片封裝技術(shù),在BGA、TSOP的基礎(chǔ)上,CSP的性能又有了革命性的提升。CSP封裝可以讓芯片面積與封裝面積之比超過1∶1.14,已經(jīng)相當接近1∶1的理想情況,絕對尺寸也僅有32平方毫米,約為普通的BGA的1/3,僅僅相當于TSOP內(nèi)存芯片面積的1/6。與BGA封裝相比,同等空間下CSP封裝可以將存儲容量提高3倍。CSP封裝內(nèi)存不但體積小,同時也更薄,其金屬基板到散熱體的最有效散熱路徑僅有0.2毫米,大大提高了內(nèi)存芯片在長時間運行后的可靠性。與BGA、TOSP相比CSP封裝的電氣性能和可靠性也有相當大的提高。并且,在相同的芯片面積下CSP所能達到的引腳數(shù)明顯要比TSOP、BGA引腳數(shù)多得多,這樣它可支持I/O端口的數(shù)目就增加了很多。