

PCB,即Printed Circuit Board的減寫,漢字譯為印制線路板,它涵蓋剛性、撓性和剛撓接合的單面、雙面和多層印制板,如圖1所示。
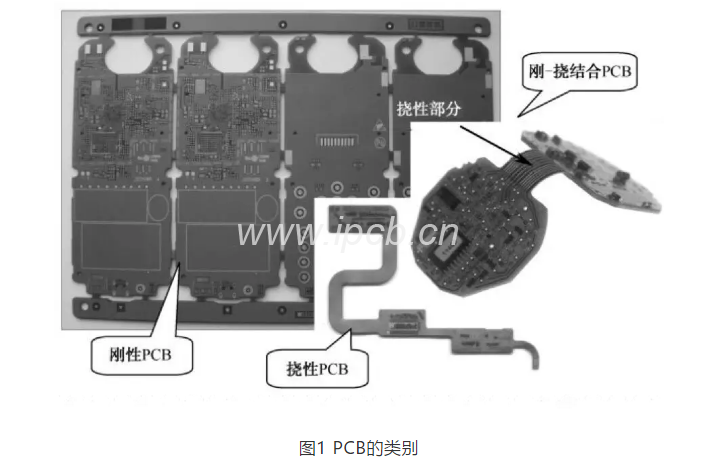
PCB為電子產品最關緊的基礎器件,用做電子元件的互連與安裝基板。不一樣門類的PCB,其制作工藝也不盡相同,但基本原理與辦法卻大概同樣,如電鍍、腐刻、阻焊等工藝辦法都要用到。在全部品類的PCB中,剛性多層PCB應用最廣,其制作工藝辦法與流程最具代表性,也是其它門類PCB制作工藝的基礎。理解PCB的制作工藝辦法與流程,掌握基本的PCB制作工藝有經驗,是做好PCB可制作性預設的基礎。本篇我們將簡單紹介傳統剛性多層PCB和高疏密程度互連PCB的制作辦法與流程以及基本工藝有經驗。
剛性多層PCB電路板是到現在為止絕大多電子產品運用的PCB電路板,其制作工藝具備一定的代表性,也是HDI電路板、撓性電路板、剛撓接合電路板的工藝基礎。
(1)工藝流程剛性多層PCB制作流程如圖2所示,可以簡單分為內層板制作、疊層/層壓、鉆孔/電鍍/外層線路制造、阻焊/外表處置四個階段。

階段一:內層板制造工藝辦法與流程如圖3所示。
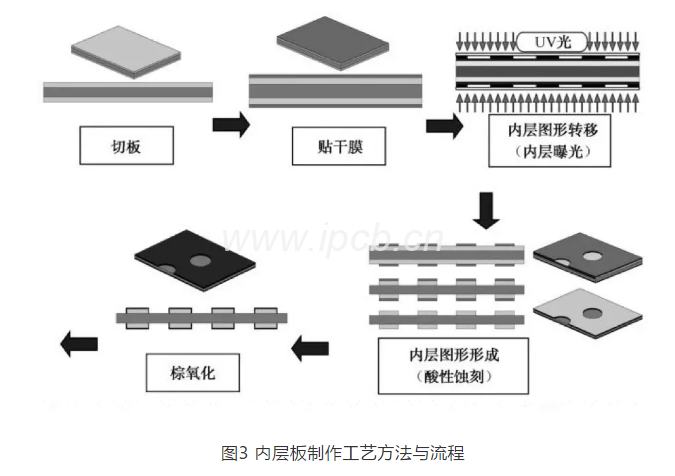
階段二:疊層/層壓工藝辦法與流程如圖4所示。
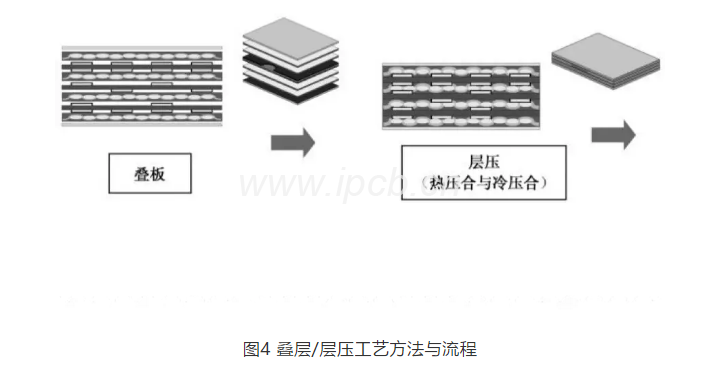
階段三:鉆孔/電鍍/外層線路板制造工藝辦法與流程如圖5所示。
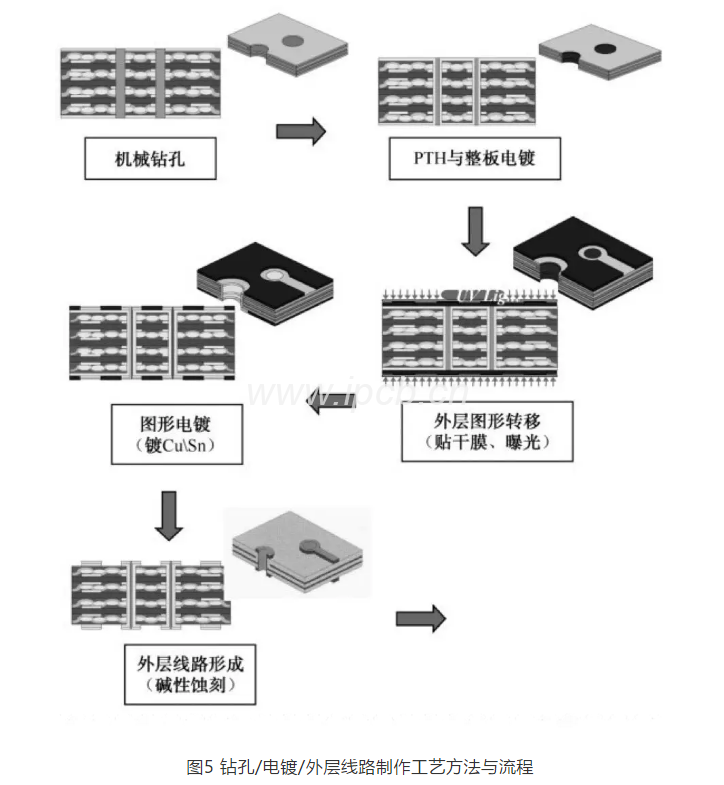
階段四:阻焊/外表處置工藝辦法與流程如圖6所示。
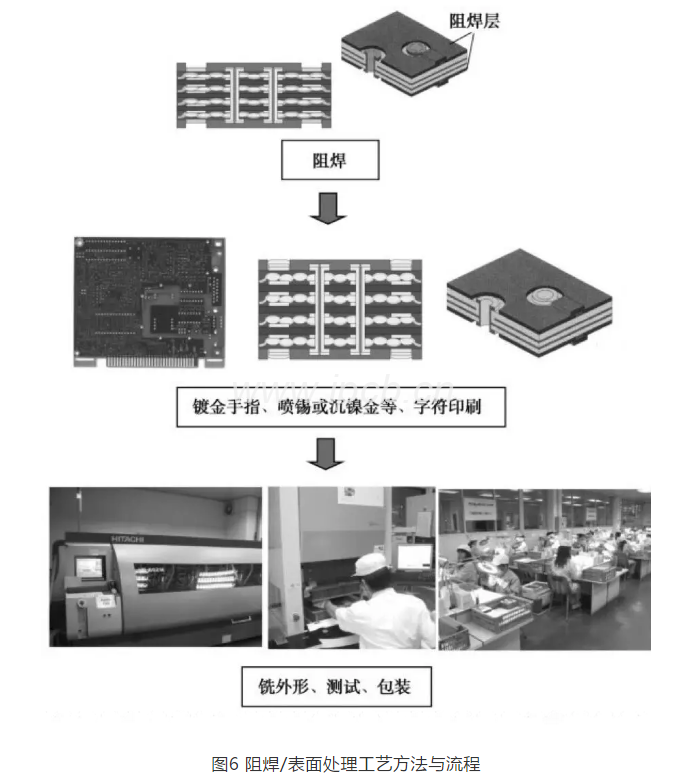
隨著0.8mm及其以下引線核心距BGA、變態C類元部件的運用,傳統的層壓印制線路板制作工藝已經不服水土微細間距元件的應用需求,因此研發了高密度互連(HDI)電路板制作技術。
所說的HDI電路板,普通是指線寬/線距小于等于0.10mm、微導通孔徑小于等于0.15mm的PCB。
在傳統的多層電路板工藝中,全部層一次性堆疊成一塊PCB電路板,認為合適而使用貫通導通孔施行層間連署,而在HDI電路板工藝中,導體層與絕緣層是逐步積層,導體間是經過微埋/盲孔施行連署的。
故而,普通把HDI電路板工藝稱為積層工藝(BUP,Build-up Process或BUM,Build-up Mutiplayer)。依據微埋/盲孔導通的辦法來分,還可以進一步細分為電鍍孔積層工藝和應用導電膏積層工藝(如ALIVH工藝和B2IT工藝)。
HDI板的典型結構是“N+C+N”,那里面“N”表達積層層數,“C”表達芯板,如圖7所示。隨著互連疏密程度的增長,全積層結構(也稱恣意層互連)也啟用。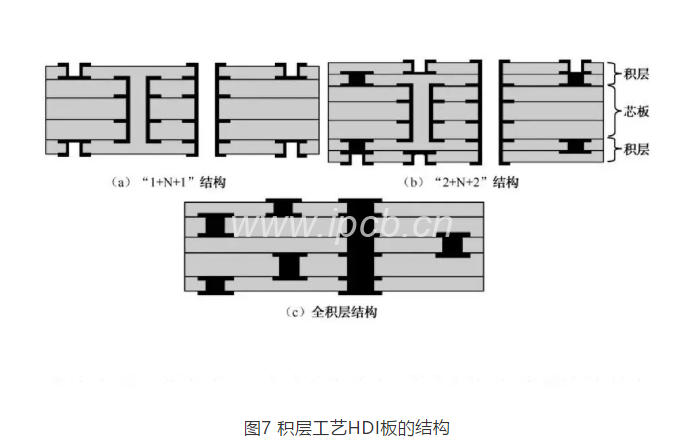
在HDI電路板的工藝中,電鍍孔工藝是主流的一種,幾乎占HDI電路板市場的95百分之百以上。它本身也在不斷進展中,從早期的傳統孔電鍍到填孔電鍍,HDI電路板的預設自由度獲得非常大增長,如圖8所示。

電鍍孔積層工藝中心流程如圖9所示。
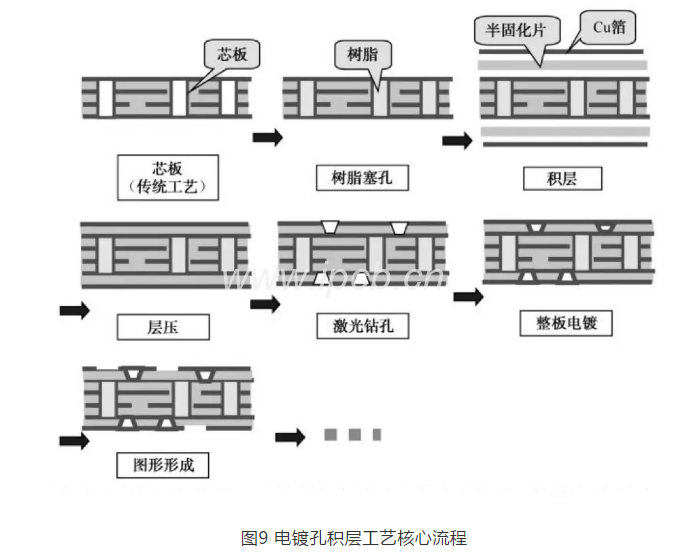
此工藝為松下企業研發的全積層結構的多層PCB制作工藝,是一種應用導電膠的積層工藝,稱為恣意層填隙式導通互連技術(Any Layer Interstitial Via Hole,ALIVH),它意味著積層的恣意層間互連全由埋/盲導通孔來成功實現。工藝的中心是導電膠填孔。
ALIVH工藝獨特的地方:
(1)運用無紡芳酰胺纖維環氧氣天然樹脂半固化片為基材;
(2)認為合適而使用CO2激光形成導通孔,并用導電膏補充導通孔。ALIVH工藝流程如圖10所示。
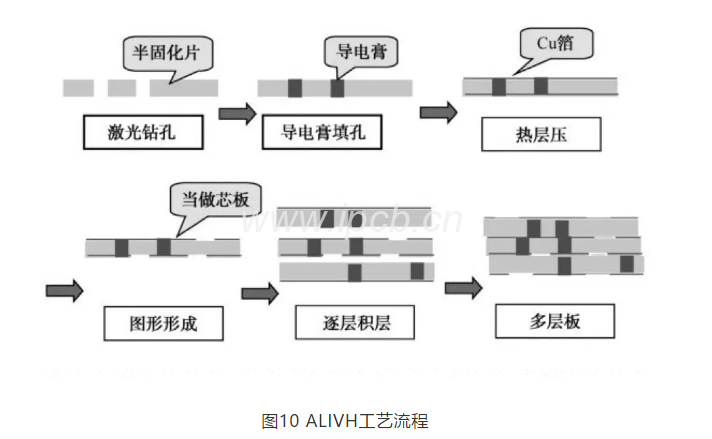
此工藝為東芝企業研發的積層多層電路板制作工藝,這種工藝稱為埋盲孔互連技術(Buried Bump Interconnection Techonology,B2IT)。工藝的中心是應用導電膏制成的凸塊。B2IT工藝流程如圖11所示。