

受電子產(chǎn)品的小、輕、薄的驅(qū)動(dòng),封裝領(lǐng)域也是不斷開發(fā)出新的封裝type。CSP封裝就是比較革命性的產(chǎn)品,Size是裸芯片的1.2倍甚至同等大小,尤其隨著移動(dòng)電子的興起,這種裸芯片封裝(Wafer Level CSP)封裝已經(jīng)是最小最省錢的封裝方式了,雖然前期需要RDL的光罩費(fèi)用,但是它省去了Leadframe的費(fèi)用,直接solder bump焊接到主板上即可。
CSP(Chip-Scale or Chipe-Size Package)的concept起源于1990s,follow的是IPC/JEDEC J-STD-012標(biāo)準(zhǔn),它主要應(yīng)用于Low pin count的EEPROMs、ASICs 以及microprocessors (MCU)等,尤其當(dāng)Wafer越大而Die又越小的時(shí)候,其成本會(huì)更有優(yōu)勢(shì)。
CSP封裝主要的步驟為: 把die mount到epoxy interposer上,再用wire bond (gold or Al)將PAD和基板連接起來,第三步用Molding Plastic封裝保護(hù)Die和Wire,最后再將Solder ball貼到Interposer底部。
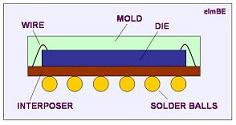
當(dāng)然上面的wire bond會(huì)讓封裝比起die size還要大一點(diǎn)。而且從die到lead frame上的導(dǎo)線還有連接阻抗的,后來發(fā)展到用bump代替wire bond,所以就發(fā)展到Flip chip代替Wire bond封裝,這樣就節(jié)省了wire bond的空間了,所以就可以做到Die幾乎等size的package了。
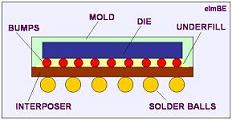
那說到倒片封裝(FC: Flip-Chip),自然就要講到這個(gè)bump了,不可能把die切割了再去長這個(gè)bump吧,所以必須在Wafer還沒切割之前就做完這個(gè)process,所以就叫做Wafer Level CSP封裝了 (WLCSP)。
Flip-Chip封裝主要的三個(gè)步驟,Die上長bumps,臉朝下把長好球的die貼倒貼到襯底或者基板上,然后填充(underfilling)。
WLCSP現(xiàn)在已經(jīng)是封裝技術(shù)的主流,主要有兩種,一種是直接BOP (Bump On Pad),還有一種是RDL (Redistribution Layer)。BOP技術(shù)還需要根據(jù)是否需要Polymer做re-passivation,再分為BON(Bump on SiN)和BOR (Bump on Repassivation)。BOP廣泛應(yīng)用于Analog/Power封裝,它由于電流是直接垂直流過,沒有橫向RDL,所以對(duì)于功率器件封裝很有優(yōu)勢(shì),Cost也很低,但是它的Pin count比較有限,所以才發(fā)展到RDL+Bump。BOP是直接把UBM/Bump錨在Top Metal的PAD上,而RDL+Bump是用Polymer (Polyimide或PBO) 隔離并布線并且把Bump與device surface隔開。

再簡單講一下RDL+Bump+銅柱的工藝流程吧,和FAB工藝差不多吧,四層光罩即可。RDL之間的dielectric用Polyimide隔離。Metal可以用電鍍長上去(Seed用Sputter)。

成型之后的RDL+Bump就是如下圖的樣子:

最早的WLCSP是Fan-In的,意思就是bump全部長在die上,而die和Pad的連接主要就是靠RDL的Metal Line來連接的。與之對(duì)應(yīng)的就是Fan-Out的WLCSP封裝,這就是把bump長到chip外面去了 (1.2倍),面積大點(diǎn),bump的壓力不會(huì)對(duì)芯片造成損傷。

講solder ball之前,還是總結(jié)一下Flip-Chip和WLCSP之間到底區(qū)別是什么?Flip-chip一般還是需要襯底的,只是它通過solder ball倒裝貼上去的(代替Wire bond)而已,而WLCSP是把長好的球做好之后直接貼到PCB板上去。
好了,不管是Flip-Chip還是WLCSP都需要一個(gè)東西叫做Solder Ball (錫球),那接下來該講解Solder Ball了,這些Bump是怎么長上去的。
先講講為啥用錫球?那就要回答一個(gè)問題,Solder Ball的技術(shù)要求是什么?
1) Fully Freflowable:類似焊錫熔融才能連接,那焊錫的要求就是加熱不能隨意流動(dòng),必須往中間聚攏(Self-Center),而且易坍塌(Collapse),這就是焊錫的特點(diǎn)。
2) 可控的Alloy成分: 一般用10~15%的錫鉛合金(63Sn/Pb)能提高液態(tài)溫度到200~215C。
3) 能兼容各種Alloy要求: 比如共晶Sn/Pb (Eutectic),High Pb,以及Sony Green提出的Pb-Free等各種Alloy來適應(yīng)市場(chǎng)要求。
4) 能控制Bump高度確保良率,厚度deviation<2.5um。
錫球的大小一般是150um, Pitch約0.5mm。也有uBump尺寸在75~130um,也有用300~500um的。一般Solder Ball Bump成分是錫鉛共晶(Sn63Pb37),但是現(xiàn)在環(huán)境污染的要求(RoHS)推出無鉛錫球等,但不管怎么變技術(shù)上重點(diǎn)是組裝回流焊的溫度曲線必須滿足特定溫度上保持一段時(shí)間(thermal budget)穩(wěn)定。
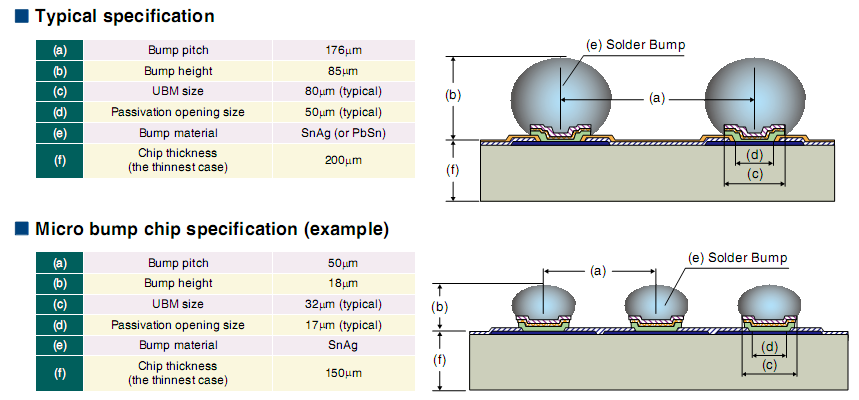
錫球工藝一般采取的工藝有: 蒸發(fā)(Evaporation)、電鍍(Electroplating)、印刷(Screen printing)、或針孔沉積(Needle depositing)等,但是Solder ball不是直接與Pad Metal連接的,類似FAB的Metal一樣,必須要有Adhesion和Barrier Layer,而這層過渡的Metal就是UBM (Under Bump Metallization),作用當(dāng)然就是Adhesion和Barrier了,而且要求必須接觸電阻低。而這個(gè)UBM通常采用Sputter或電鍍的方式都可以實(shí)現(xiàn)。最后用常用的電鍍法講述錫球形成的過程(最后一步Bump Shaping是通過第六步的形狀回流后包裹成型的)。

好了,至此就講完了WLCSP和Flip-chip了(技術(shù)細(xì)節(jié)請(qǐng)參閱《Wafer-Level Chip-Scale Packaging》--Shichun Qu, Yong Liu, Springer Science),這也是現(xiàn)在中低端消費(fèi)類市場(chǎng)的主流封裝模式了,高端市場(chǎng)當(dāng)然就是SiP的3D封裝了,再開一篇吧。敬請(qǐng)期待!
